Al預(yù)沉積層對金屬有機物化學(xué)氣相沉積方法在Si襯底上生長AlN緩沖層和GaN外延層的影響
摘要
采用金屬有機物化學(xué)氣相沉積法(MOCVD)在硅(Si)襯底制備鋁/氮化鋁/氮化鎵(Al/AlN/GaN)多層薄膜,使用光學(xué)顯微鏡(OM)、原子力顯微鏡(AFM)、X射線衍射(XRD)等手段表征AlN和GaN薄膜的微觀結(jié)構(gòu)和晶體質(zhì)量,研究了TMAl流量對AlN薄膜和GaN薄膜的形核和生長機制的影響。結(jié)果表明,預(yù)沉積Al層能促進AlN的形核和生長,進而提高GaN外延層的薄膜質(zhì)量。TMAl流量太低則預(yù)沉積Al層不充分,AlN緩沖層的質(zhì)量取決于由形核長大的高結(jié)晶度AlN薄膜與在氣氛中團聚長大并沉積的低結(jié)晶度AlN薄膜之間的競爭,AlN薄膜的質(zhì)量隨著TMAl流量的升高而提高,GaN薄膜的質(zhì)量也隨之提高。TMAl流量太高則預(yù)沉積Al層過厚,AlN緩沖層的質(zhì)量取決于由形核長大的高結(jié)晶度AlN薄膜與Al-Si回融蝕刻之間的競爭,AlN薄膜的質(zhì)量隨著TMAl流量的升高而降低,GaN薄膜的質(zhì)量也隨之降低。
關(guān)鍵詞: 材料表面與界面 ; 生長機制 ; 金屬有機物化學(xué)氣相沉積 ; Al預(yù)沉積 ; Si襯底 ; GaN薄膜
Abstract
Multilayered films of Al/AlN/GaN were deposited on a Si wafer by metal-organic chemical vapor deposition (MOCVD)。 The microstructure and crystallinity were characterized by means of optical microscopy (OM), atomic force microscopy (AFM) and X-ray diffractometer (XRD), especially in terms of the mechanisms of nucleation and growth of the produced AlN and GaN films with the variations of trimethylaluminum (TMAl) flow during Al pre-deposition process. It was observed that the pre-deposited Al layer helps the nucleation and growth of AlN film and thereafter improves the quality of GaN film. When a thin Al layer was deposited at low TMAl flow, the quality of the AlN film depends on the competition between the nucleation and growth of the high crystallinity AlN thin film with the deposition of the formed clasters of low crystallinity AlN in the gas phase on the surface of silicon wafer. The quality of the AlN film increases with increasing TMAl flow, inducing the formation of GaN film with better quality. When the Al layer is too thick at high TMAl flow, the quality of the AlN film depends on the competition between the nucleation and growth of the high crystallinity AlN thin film with the meltback-etching of Al-Si on the wafer surface. The quality of the AlN film decreases with increasing TMAl flow, inducing the formation of GaN film with worse quality.
Keywords: surface and interface in the materials ; growth mechanism ; MOCVD ; Al pre-deposition ; Si substrate ; GaN film
PDF (14446KB) 元數(shù)據(jù) 多維度評價 相關(guān)文章 導(dǎo)出 EndNote| Ris| Bibtex 收藏本文
本文引用格式
甄龍云, 彭鵬, 仇成功, 鄭蓓蓉, Armaou Antonios, 鐘蓉。 Al預(yù)沉積層對金屬有機物化學(xué)氣相沉積方法在Si襯底上生長AlN緩沖層和GaN外延層的影響。 材料研究學(xué)報[J], 2020, 34(10): 744-752 doi:10.11901/1005.3093.2020.159
ZHEN Longyun, PENG Peng, QIU Chenggong, ZHENG Beirong, ARMAOU Antonios, ZHONG Rong. Effect of Pre-deposited Al Layer on Growth of AlN Buffer Layer and GaN Film on Si Substrate by Metal-organic Chemical Vapor Deposition. Earth Science[J], 2020, 34(10): 744-752 doi:10.11901/1005.3093.2020.159
近年來,隨著薄膜制備技術(shù)的發(fā)展和制備設(shè)備的改善氮化鎵(GaN)基器件在學(xué)術(shù)和商業(yè)上的應(yīng)用都有很大的進展。作為第三代半導(dǎo)體的代表性材料,GaN材料有大禁帶寬度、很高的飽和電子漂移速率、高擊穿電場、強抗腐蝕性、高熔點、耐高溫、化學(xué)穩(wěn)定性好和高熱導(dǎo)率等特性。因此,GaN的制備方法、理論探索和應(yīng)用研究都備受關(guān)注,也是當(dāng)前研究的熱點和難點。由于缺少天然襯底,生長GaN薄膜通常使用藍寶石(Al2O3)或碳化硅(SiC)襯底。與這些襯底材料相比,硅(Si)具有導(dǎo)熱性高、導(dǎo)電性高、尺寸大、可用性強以及成本低等優(yōu)點,是一種很有前途的襯底材料。但是,與藍寶石和SiC襯底相比,Si與GaN之間的晶格失配更大(17%)、熱失配更高(56%),限制了它的應(yīng)用。在外延生長過程中,高晶格失配使GaN薄膜的缺陷密度高;在外延生長結(jié)束后的降溫過程中,高熱失配使GaN薄膜產(chǎn)生更大的張應(yīng)力,從而產(chǎn)生大量裂紋。同時,外延生長的溫度很高,使襯底的Si原子擴散到GaN外延層并與Ga原子反應(yīng)生成Ga-Si共晶合金,從而使Si表面出現(xiàn)空洞。這種強烈而快速的刻蝕反應(yīng),通常稱為“熔融反刻蝕”[1]。由此可見,在Si襯底上異質(zhì)外延生長GaN薄膜的困難比在藍寶石或SiC襯底上生長大得多。
為了制備高質(zhì)量、無裂紋的GaN薄膜,文章[2~7]針對緩沖層的材料選擇和膜層設(shè)計提出了幾種方法,包括用圖案化襯底引導(dǎo)Si襯底掩模或刻蝕部分的裂紋[2]、襯底工程[3]和引入高溫(HT)AlN緩沖層[4]與低溫(LT)進行拉應(yīng)力補償AlN中間層[5]、Al GaN中間層[6]或Al(Ga)N/GaN多層膜[7]。另外,采用Si的delta摻雜技術(shù)可緩解Si與GaN之間的晶格失配度并產(chǎn)生預(yù)壓應(yīng)力,從而降低外延生長過程中生成的位錯密度并減小冷卻過程中產(chǎn)生的張應(yīng)力。這些技術(shù)可以緩解或消除裂紋,從而提高GaN外延層的結(jié)晶質(zhì)量[8]。但是,裂紋問題仍然沒有徹底解決,GaN外延層的結(jié)晶質(zhì)量不能滿足高質(zhì)量芯片的要求。由于AlN與GaN材料具有較高的結(jié)構(gòu)相似性,可用AlN作緩沖層在Si襯底生長GaN [9]。而Al預(yù)沉積層決定AlN緩沖層的質(zhì)量,并進而影響GaN外延層的質(zhì)量[9-11]。鑒于此,本文研究Al預(yù)沉積層對AlN緩沖層和GaN外延層的影響并給出Al預(yù)沉積層的最佳生長參數(shù)。
1 實驗方法
實驗用樣品在Aixtron G4 2800 HT型金屬有機物化學(xué)氣相沉積(MOCVD)系統(tǒng)上生長,襯底為4英寸商業(yè)Si(111)晶片。三甲基鋁(TMAl)、三甲基鎵(TMGa)和氨氣(NH3)分別用作鋁(Al)、鎵(Ga)和氮(N)源的前體氣體,載氣為氫氣(H2)。制備Al/AlN/GaN多層薄膜結(jié)構(gòu)的流程為:
(1) 將Si襯底放在MOCVD設(shè)備內(nèi),反應(yīng)室的溫度設(shè)置為950℃,反應(yīng)室壓力設(shè)置為20 MPa,通入H2氣10 min對Si襯底表面的氧化物進行還原反應(yīng)。這個過程稱作烘焙解吸過程(Desorption)。
(2) 烘焙解吸過程結(jié)束后,將反應(yīng)室溫度設(shè)置為980℃,反應(yīng)室壓力設(shè)置為5 MPa,載氣為H2,通入TMAl作為Al源在Si襯底上進行Al層的沉積生長。Al層沉積時間為36 s,TMAl的流量分別為0、41.5、59.5和77.5 sccm。
(3) 預(yù)沉積Al層后,在反應(yīng)室溫度、壓力、載氣不變的條件下通入190 sccm的TMAl作為Al源,通入兩路NH3作為N源(分別為NH3_Top和NH3_Bottom),其流量分別為1350和1650 sccm,在Al預(yù)沉積層上生長AlN緩沖層,生長時間為1600 s。
(4) 制備AlN緩沖層后,在反應(yīng)室溫度、載氣不變的就下將反應(yīng)室壓力設(shè)置為100 mbar,通入190 sccm的TMGa作為Ga源,通入NH3_Top和NH3_Bottom作為N源,其流量分別為1350和1650 sccm,在AlN緩沖層上生長GaN外延層,生長時間為1600 s,厚度約為1 μm。
用Dimension 3100原子力顯微鏡(AFM)觀察AlN緩沖層的表面形貌并測量表面粗糙度,用OLYM-PUS光學(xué)顯微鏡(OM)觀察GaN外延層的表面形貌,用D8 Discover高分辨X射線衍射儀(HRXRD)表征AlN緩沖層和GaN外延層的晶體質(zhì)量。
2 實驗結(jié)果
2.1 AlN緩沖層的質(zhì)量
保持Al層預(yù)沉積過程中的條件不變,改變TMAl流量以調(diào)整Al層的沉積量,從而在AlN的MOCVD制備過程中控制Si襯底上AlN的形核數(shù)量,最終影響AlN緩沖層的質(zhì)量。
圖1給出了對應(yīng)不同TMAl流量制備出的AlN緩沖層的AFM照片。可以看出,照片的掃描尺寸為2×2 μm2,其中白色部分為呈島狀生長的AlN薄膜,黑色部分為連成網(wǎng)狀的孔洞。用AFM掃描區(qū)域的均方根粗糙度(RRMS)表示AlN薄膜的表面粗糙度(圖2)。

圖1 TMAl流量分別為 0 sccm、41.5 sccm、59.5 sccm和77.5 sccm預(yù)沉積Al層后在Si襯底上生長的AlN薄膜的AFM照片

圖2 TMAl流量不同的AlN薄膜的均方根粗糙度RRMS
如圖1a所示,直接在Si襯底上制備AlN緩沖層(TMAl流量為0 sccm)AlN島的尺寸很小且分布極不均勻,孔洞分為連成網(wǎng)狀的小孔洞和由大量小孔洞聚集而成的大孔洞,大孔洞貫穿AlN層使Si襯底表面裸露出來,AFM測試顯示其RRMS值為6.305 nm。隨著TMAl流量的增大,如圖1a~c所示,AlN島的尺寸增大、分布更為均勻,網(wǎng)狀孔洞的寬度變小且分布更為均勻,貫穿性大孔洞尺寸和數(shù)量均大幅度降低,且AFM測試顯示的RRMS值也隨之降低(圖2)。但是,當(dāng)TMAl流量繼續(xù)增大時,如圖1c~d所示,AlN島均勻分布但是尺寸減小,網(wǎng)狀孔洞均勻分布但是寬度變大,且AFM測試顯示的RRMS值隨之升高(圖2)。因此,TMAl流量為59.5 sccm時可制備出最佳的AlN薄膜表面質(zhì)量,此時AlN島的尺寸最大且分布最均勻,網(wǎng)狀孔洞的寬度最小且分布最均勻,大孔洞消完全消失,且表面粗糙度達到最低值4.875 nm。
在相同測試條件下對比XRD搖擺曲線的峰值強度可判斷薄膜的結(jié)晶程度,根據(jù)半高寬(FWHM)判斷晶粒尺寸。圖3給出了用不同TMAl流量制備的AlN (002)面的XRD搖擺曲線的強度及其半高寬。直接在Si襯底上制備AlN緩沖層時(TMAl流量為0 sccm),用XRD掃描無法得到AlN (002)面的搖擺曲線。隨著TMAl流量的增大AlN (002)面的搖擺曲線強度提高而半高寬(FWHM)降低,即AlN薄膜的結(jié)晶程度隨之提高且晶粒尺寸隨之增大。當(dāng)TMAl流量超過59.5 sccm時,隨著TMAl流量繼續(xù)增大AlN (002)面的搖擺曲線的強度反而下降但FWHM升高,即AlN薄膜的結(jié)晶程度隨之降低且晶粒尺寸隨之減小。因此,TMAl流量為59.5 sccm時可制備出質(zhì)量最佳的AlN薄膜結(jié)晶,此時AlN (002)面的搖擺曲線強度達到最高值,F(xiàn)WHM 達到最低值1538 arcsec,即AlN薄膜的結(jié)晶程度最高且晶粒尺寸最大。

圖3 TMAl流量不同的預(yù)沉積Al層,相應(yīng)AlN (002)面的XRD搖擺曲線的強度及其半高寬
綜上所述,AFM表征和XRD分析結(jié)果都表明,在Si襯底上預(yù)沉積Al層是生長AlN薄膜晶體的前提條件。在本文的實驗條件下,TMAl流量的優(yōu)化值為59.5 sccm,制備出的AlN薄膜的表面形貌和結(jié)晶質(zhì)量都最佳。
2.2 GaN外延層的質(zhì)量
在上述條件下制備出的AlN緩沖層上繼續(xù)生長厚度約為1 μm的GaN薄膜。圖4給出了對應(yīng)不同TMAl流量、

圖4 TMAl流量分別為 0 sccm、41.5 sccm、59.5 sccm和77.5 sccm的GaN薄膜的OM照片
經(jīng)過整個制備過程得到的GaN外延層的OM照片。當(dāng)TMAl的流量為0 sccm時,如圖4a所示,GaN薄膜表面由大量灰色GaN區(qū)域和回融蝕刻引起的黑色坑洞組成,此時未觀察到鏡面區(qū)域。隨著TMAl流量的增大,如圖4b所示,GaN薄膜表面出現(xiàn)了鏡面區(qū)域,且在該鏡面區(qū)域觀察到大量的交叉裂紋,裂紋分3個方向拓展(圖中箭頭所示),彼此之間呈60°角。GaN具有纖鋅礦纖鋅礦型結(jié)構(gòu)(六方硫化鋅型結(jié)構(gòu)),因此這種裂紋的方向為<112?0>方向,而GaN薄膜表面為(0001)面。此時仍然發(fā)生少量的回融蝕刻現(xiàn)象(圖中圓圈所示),且薄膜中存在大量的點狀孔洞(pinhole)。隨著TMAl流量繼續(xù)增大,如圖4c所示,GaN薄膜的鏡面區(qū)域擴大呈全鏡面生長,且鏡面區(qū)域觀察到平行裂紋和極少量的交叉裂紋,此時未發(fā)現(xiàn)回融蝕刻和點狀孔洞。但是,當(dāng)TMAl流量繼續(xù)增大時,如圖4d所示,GaN薄膜的鏡面區(qū)域仍然呈全鏡面生長,但鏡面區(qū)域中的3個方向拓展的交叉裂紋增多,且重新出現(xiàn)回融蝕刻現(xiàn)象和點狀孔洞。因此,TMAl流量為59.5 sccm時可制備出表面質(zhì)量最佳的GaN薄膜,此時GaN薄膜呈全鏡面生長且缺陷最少。
GaN外延層的結(jié)晶質(zhì)量,也可用XRD測量GaN (0002)面的搖擺曲線分析和判斷。圖5給出了對應(yīng)不同TMAl流量的GaN (0002)面的XRD搖擺曲線的強度及其半高寬。當(dāng)TMAl流量小于41.5 sccm時,隨著TMAl流量的增大GaN (0002)面的搖擺曲線的強度升高且半高寬(FWHM)降低,即GaN著薄膜的結(jié)晶程度隨之提高且晶粒尺寸隨之增大。當(dāng)TMAl流量大于59.5 sccm時,隨著TMAl流量的增大GaN (0002)面的搖擺曲線的強度反而下降且FWHM升高,即GaN著薄膜的結(jié)晶程度隨之降低且晶粒尺寸隨之減小。最后對比TMAl流量為41.5和59.5 sccm時的搖擺曲線可以發(fā)現(xiàn),前者的曲線強度比后者約高10%,但是其FWHM數(shù)值也比后者(866 arcsec)約高16%。這意味著,雖然前者的結(jié)晶度稍好但后者的晶粒尺寸更大。因此可綜合判斷,TMAl流量為59.5 sccm時可制備出結(jié)晶質(zhì)量最佳的GaN薄膜。
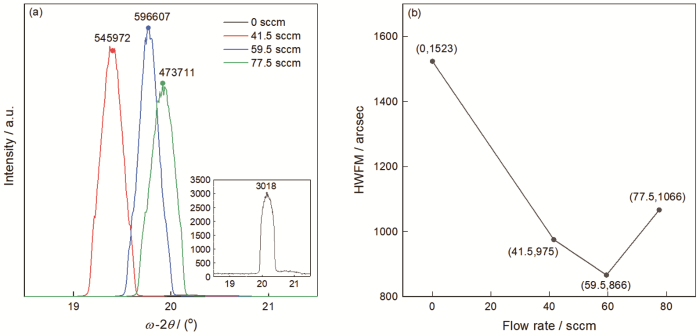
圖5 采用不同TMAl流量預(yù)沉積Al層時相應(yīng)GaN (0002)面的XRD搖擺曲線的強度及其半高寬
OM表征和XRD分析結(jié)果都表明,在本文的實驗條件下TMAl流量的優(yōu)化值為59.5 sccm,制備的GaN薄膜的表面形貌和結(jié)晶質(zhì)量都是最佳的。對比圖1和圖4、圖3和圖5都可以發(fā)現(xiàn),GaN薄膜質(zhì)量與AlN緩沖層質(zhì)量的趨勢一致,即制備結(jié)晶質(zhì)量高的AlN緩沖層是制備高質(zhì)量GaN外延層的前提條件。
3 討論
在實驗中,用鼓泡法將MO源(TMAl或TMGa)由載氣H2帶入MOCVD的反應(yīng)室中,并通入兩路NH3作為反應(yīng)物,該混合氣體稱為氣氛。在高于900 ℃的高溫條件下,MOCVD的反應(yīng)室中同時存在分解反應(yīng)、化合反應(yīng)、襯底表面的吸附過程、襯底表面的原子擴散過程、襯底表面的薄膜形核和長大過程、氣氛中顆粒團聚及沉積過程。各反應(yīng)機制通過相互之間的制約和競爭達到動態(tài)平衡。因此該反應(yīng)系統(tǒng)對參數(shù)變化極為敏感,任何微小的變化都可能導(dǎo)致不同的實驗結(jié)果。
3.1 預(yù)沉積Al層的生長機制
在這個過程中,在MOCVD反應(yīng)室中通入反應(yīng)氣體TMAl。TMAl經(jīng)過表1中的一系列的化學(xué)反應(yīng),可生成Al原子和CH3。其中Al原子被捕獲并吸附在Si襯底的表面(S1-S3),其余混合氣體則被H2帶離反應(yīng)室。由于整個沉積過程只持續(xù)36 s,Al原子來不及在Si襯底中進行擴散,因此只沉積在Si襯底的表面,且沉積量隨著TMAl流量的升高而升高。
表1 不預(yù)沉積Al層時氣相-表面的化學(xué)反應(yīng)

3.2 AlN緩沖層的生長機制
在這個過程中,向MOCVD反應(yīng)室通入反應(yīng)氣體TMAl和NH3。由于本文實驗的溫度范圍為900-1000 ℃,此時NH3只有在有催化劑的情況下才能發(fā)生分解反應(yīng)生成N2和H2,因此反應(yīng)室中發(fā)生了列于表1和表2中的化學(xué)反應(yīng)。其中Al原子被襯底表面捕獲(S1-S3);襯底上的Al反應(yīng)生成AlN(S4)或生成Al-Si合金(S5)[12];襯底上的Si表面部分反應(yīng)生成SixNy(S6),其余部分不變;在氣氛中可生成AlN(G7)并沉積到襯底表面(S7),或被H2帶出反應(yīng)室。
表2 生長AlN緩沖層時氣相-表面的化學(xué)反應(yīng)

在AlN的生長過程中,以上幾種機制相互牽制:
(1) 當(dāng)襯底表面為Al原子時可反應(yīng)生成AlN形核點,并不斷吸收氣氛中的AlN而長大。這部分AlN薄膜(稱為AlN生長薄膜)的結(jié)晶度高、表面光滑致密、缺陷少。
(2) 當(dāng)襯底表面為Si原子時,由于“吸附Al原子+AlN形核”的過程較慢,因此只形成“Si+SixNy”混合表面,氣氛中的AlN團聚成細(xì)小顆粒并沉積到該表面。這部分AlN薄膜(稱為AlN沉積薄膜)的結(jié)晶度低、表面粗糙疏松、孔洞較多。
(3) 當(dāng)襯底表面的Al原子過多時,Al原子在Si襯底中擴散并形成Al-Si合金,從而出現(xiàn)回融刻蝕現(xiàn)象并造成均勻分布的細(xì)小孔洞。
以上三種進程相互競爭,決定了最終的AlN薄膜質(zhì)量:
(1) 在無預(yù)沉積Al層的情況下(TMAl流量為0 sccm),Si襯底表面生成“Si+SixNy”混合表面并被AlN沉積薄膜覆蓋。因此樣品表面的形貌如圖1a所示,AlN島的尺寸最小且分布不均勻,存在密集的網(wǎng)狀小孔洞和大量的貫穿性大孔洞缺陷,表面粗糙度大,且XRD檢測不到其結(jié)晶度(圖2)。
(2) 當(dāng)TMAl流量提高到41.5 sccm時Si襯底表面部分被Al原子預(yù)覆蓋,生成AlN生長薄膜;其余襯底表面仍生成“Si+SixNy”混合表面,并被AlN沉積薄膜覆蓋。因此樣品的表面形貌如圖1b所示,AlN島的尺寸增大且分布更為均勻,網(wǎng)狀小孔洞和貫穿性的孔洞顯著改善,表面粗糙度也有所降低,且XRD顯示有AlN晶體生成(圖2)。
(3) 當(dāng)TMAl流量提高到59.5 sccm時Si襯底表面全部被Al原子預(yù)覆蓋,普遍生成AlN生長薄膜。因此樣品表面的形貌如圖1c所示,AlN島的尺寸最大且分布均勻,網(wǎng)狀小孔洞分布均勻且沒有貫穿性大孔洞,表面粗糙度最低,而XRD顯示AlN薄膜的結(jié)晶度也達到了最高值(圖2),說明此時AlN薄膜的質(zhì)量最佳。
(4) 當(dāng)TMAl流量提高到77.5 sccm時,Si襯底表面全部被過量的Al原子預(yù)覆蓋,在普遍形成AlN生長薄膜后剩余的Al原子與Si襯底形成Al-Si合金,在襯底表面形成大量回融蝕刻現(xiàn)象造成的細(xì)小且分布均勻的孔洞。因此樣品表面形貌如圖1d所示,回融刻蝕現(xiàn)象造成的孔洞惡化了網(wǎng)狀小孔洞,使AlN島尺寸減小、表面粗糙度提高,XRD顯示AlN薄膜的結(jié)晶度再次降低(圖2),說明此時AlN薄膜質(zhì)量有所下降。
綜上所述,AlN的薄膜質(zhì)量取決于Al原子在Si襯底上的預(yù)沉積量。Al預(yù)沉積量過多或過少,都破壞AlN在襯底表面的結(jié)晶生長,從而影響薄膜的質(zhì)量。在本實驗中,采用59.5 sccm的TMAl流量可制備出最佳的Al預(yù)沉積量,最終制備出質(zhì)量最佳的AlN薄膜。
3.3 GaN緩沖層的生長機制
在這個過程中,在MOCVD反應(yīng)室中通入反應(yīng)氣體TMGa和NH3。在反應(yīng)室中發(fā)生如表3所示的化學(xué)反應(yīng)[13],其中Ga原子被襯底表面捕獲(S8-S10);沉積在AlN表面的Ga與氣氛反應(yīng)生成GaN形核點(S11);沉積在Si表面的Ga則形成Ga-Si合金(S12);襯底上的Si表面部分反應(yīng)生成SixNy(S13),其余部分不變;在氣氛中生成GaN(G13)并沉積到襯底表面(S14),或被H2帶出反應(yīng)室。
表3 生長GaN緩沖層時氣相-表面的化學(xué)反應(yīng)

Note: G—gas, S—surface
如圖1所示,AlN外延層主要由AlN島、網(wǎng)狀小孔洞和貫穿性大孔洞組成:
(1) 當(dāng)襯底表面為AlN島時可吸附Ga原子形成AlxGa1-xN,并與氣氛反應(yīng)生成GaN形核點,之后不斷吸收氣氛中的GaN而長大。這部分GaN薄膜(稱為GaN生長薄膜)具有結(jié)晶度高、表面光滑致密、缺陷少等特點。
(2) 在貫穿性大孔洞處,在襯底表面生成“Si+SixNy”混合表面,氣氛中的GaN團聚形成極細(xì)的GaN顆粒(非晶或者納米晶)并沉積到該表面,這部分GaN薄膜(稱為GaN沉積薄膜)具有結(jié)晶度低、表面粗糙疏松、孔洞多等特點。同時,Si表面吸附Ga原子形成Ga-Si合金,產(chǎn)生回融刻蝕現(xiàn)象并形成很大的孔洞缺陷。
(3) 在網(wǎng)狀小孔洞處,當(dāng)孔洞寬度足夠小時,從孔洞兩邊的AlN島長大的GaN愈合并形成GaN生長薄膜;當(dāng)孔洞寬度超過門檻值,從孔洞兩邊的AlN島長大的GaN無法愈合,此時孔洞表面生成“Si+SixNy”混合表面,同時形成GaN沉積薄膜覆蓋和均勻分布的回融蝕刻小孔洞。在隨后的冷卻過程中GaN薄膜產(chǎn)生了內(nèi)拉應(yīng)力并在回融刻蝕小孔洞處發(fā)生應(yīng)力集中,因此裂紋沿著GaN薄膜表面的3個<112?0>晶向呈60°夾角均勻分布。
這三種進程互相競爭,決定了最終的GaN薄膜形貌與質(zhì)量:
(1) 在無預(yù)沉積Al層的情況下(TMAl流量為0 sccm),AlN薄膜具有尺寸最小的AlN島、最密集的網(wǎng)狀小孔洞和大量的貫穿性大孔洞。因此樣品表面形貌如圖3a所示,雖然XRD顯示有GaN晶體生成(圖4),但是GaN薄膜主要由結(jié)晶度低的GaN沉積薄膜組成,不能形成鏡面且出現(xiàn)大量回融蝕刻產(chǎn)生的黑色坑洞。
(2) 當(dāng)TMAl流量提高到41.5 sccm時AlN島的尺寸增大,網(wǎng)狀小孔洞減少且貫穿性大孔洞顯著改善。此時部分網(wǎng)狀小孔洞的寬度小于門檻值,在其上生長的GaN薄膜得以愈合。因此樣品表面形貌如圖3b所示,GaN薄膜形成了鏡面區(qū)域,XRD也顯示GaN的結(jié)晶質(zhì)量有所提高(圖4)。此時在鏡面區(qū)域可觀察到均勻分布的交叉裂紋、大量的點狀孔洞和少量回融蝕刻缺陷。
(3) 當(dāng)TMAl流量提高到59.5 sccm時AlN島的尺寸最大,網(wǎng)狀小孔洞進一步減少且消除了貫穿性大孔洞。此時網(wǎng)狀小孔洞的寬度都低于門檻值,不再影響GaN生長薄膜的愈合。因此樣品表面形貌如圖3c所示,GaN薄膜的鏡面區(qū)域增大且呈全鏡面生長,XRD顯示GaN結(jié)晶質(zhì)量最高(圖4)。此時在鏡面區(qū)域未觀察到回融蝕刻缺陷或點狀孔洞,且裂紋由平行裂紋和極少量交叉裂紋組成。其原因是,回融刻蝕小孔洞大量減少,為了釋放冷卻過程中產(chǎn)生的內(nèi)拉應(yīng)力裂紋沿著與拉應(yīng)力方向夾角更小的那個<111>晶向形成并平行分布。這表明,此時的GaN薄膜質(zhì)量最佳。
(4) 當(dāng)TMAl流量提高到77.5 sccm時,AlN島的尺寸減小、網(wǎng)狀小孔洞增多,且出現(xiàn)由Al-Si造成的回融刻蝕孔洞。此時網(wǎng)狀小孔洞的寬度仍然足夠小,不影響AlN表面形成的高結(jié)晶度的GaN薄膜的愈合,但是在回融刻蝕孔洞處形成GaN沉積薄膜或被Ga-Si回融刻蝕加深,因此其表面形貌如圖3d所示。GaN薄膜的鏡面區(qū)域不變,但XRD顯示GaN結(jié)晶質(zhì)量有所降低(圖4),此時除了平行裂縫外又重新觀察到更多的交叉裂紋、大量的點狀孔洞和少量回融蝕刻缺陷,說明GaN薄膜質(zhì)量有所下降。
GaN的薄膜質(zhì)量,取決于AlN的薄膜質(zhì)量。在本實驗中,TMAl流量為59.5 sccm可制備出質(zhì)量最佳的AlN薄膜和GaN薄膜。
4 結(jié)論
(1) 在Si (111)襯底上預(yù)沉積Al層是生長高質(zhì)量AlN薄膜的前提條件,而高質(zhì)量AlN薄膜是生長高質(zhì)量GaN薄膜的前提條件。GaN薄膜表面為(0001)晶面,裂紋方向為<112?0>晶向。
(2) 在本文的實驗條件下TMAl流量的最佳值為59.5 sccm,Si襯底由表面Al和N原子形核長大的AlN緩沖層組成,其結(jié)晶度最高且表面缺陷最少;在AlN緩沖層上因吸附Ga原子而形核長大的GaN外延層,其結(jié)晶度最高且表面缺陷最少,呈全鏡面生長且缺陷為平行裂紋和少量交叉裂紋。
(3) 在TMAl流量低于最佳值且降低時,Si襯底由形核長大的AlN薄膜和沉積而成的AlN薄膜組成,其結(jié)晶度降低且表面缺陷增加;在AlN緩沖層上形核長大成GaN外延層并發(fā)生Ga-Si回融刻蝕現(xiàn)象,其結(jié)晶度降低且表面缺陷增加,鏡面區(qū)域變小,缺陷由平行裂紋轉(zhuǎn)變?yōu)榻徊媪鸭y,回融刻蝕缺陷增多。
(4) 在TMAl流量高于最佳值且量提高時,在Si襯底上形核長大成AlN緩沖層并發(fā)生Al-Si回融刻蝕現(xiàn)象,其結(jié)晶度降低且表面缺陷增加;在AlN緩沖層上形核長大成GaN外延層并發(fā)生Ga-Si回融刻蝕現(xiàn)象,其結(jié)晶度降低且表面缺陷增加呈全鏡面生長,缺陷由平行裂紋轉(zhuǎn)變?yōu)榻徊媪鸭y且回融刻蝕缺陷增多。
參考文獻
[1]
Zhu D, Wallis D J, Humphreys C J.
Prospects of III-nitride optoelectronics grown on Si
[J]. Rep. Prog. Phys., 2013, 76(10): 106501
DOI:10.1088/0034-4885/76/10/106501 URL PMID:24088511 [本文引用: 1]
[2]
Zhang B, Liang H, Wang Y, et al.
High-performance III-nitride blue LEDs grown and fabricated on patterned Si substrates
[J]. J. Cryst. Growth., 2007, 298(Jan): 725
DOI:10.1016/j.jcrysgro.2006.10.170 URL [本文引用: 2]
[3]
Jamil M, Grandusky J R, Jindal V, et al.
Development of strain reduced GaN on Si (111) by substrate engineering
[J]. Appl. Phys. Lett., 2005, 87(8): 082103
DOI:10.1063/1.2012538 URL [本文引用: 1]
[4]
Bak S J, Mun D H, Jung K C, et al.
Effect of Al pre-deposition on AlN buffer layer and GaN film grown on Si (111) substrate by MOCVD
[J]. Electron. Mater. Lett., 2013, 9(3): 367
DOI:10.1007/s13391-013-2203-6 URL [本文引用: 1]
[5]
Luo R, Xiang P, Liu M, et al.
Influence of V/III ratio of low temperature grown AlN interlayer on the growth of GaN on Si substrate
[J]. Jpn. J. Appl. Phys, 2011, 50(10): 105501
[本文引用: 1]
[6]
Krishnan B, Lee S, Li H, et al.
Growth of Al-xGa-(1-x)N structures on 8 in Si(111) Substrates
[J]. Sens. Mater., 2013, 25(3): 205
[本文引用: 1]
[7]
Su J, Armour E A, Krishnan B, et al.
Stress engineering with AlN/GaN superlattices for epitaxial GaN on 200 mm silicon substrates using a single wafer rotating disk MOCVD reactor
[J]. J. Mater. Res., 2015, 30(19): 2846
DOI:10.1557/jmr.2015.194 URL [本文引用: 2]
[8]
Krost A, Dadgar A.
GaN-based optoelectronics on silicon substrates
[J]. Mater. Sci. Eng. B., 2002, 93(1-3): 77
DOI:10.1016/S0921-5107(02)00043-0 URL [本文引用: 1]
[9]
Cao J, Li R, Fan R, et al.
The influence of the Al pre-deposition on the properties of AlN buffer layer and GaN layer grown on Si (111) substrate
[J]. J. Cryst. Growth., 2010, 312(14): 2044
DOI:10.1016/j.jcrysgro.2010.03.032 URL [本文引用: 2]
[10]
Kim J O, Hong S K, Lim K Y.
Crack formation in GaN on Si(111) substrates grown by MOCVD using HT Al-preseeding and HT AlN buffer layers
[J]. Phys. Status Solid., 2010, 7(7-8): 2052
[11]
Chen Y, Song H, Jiang H, et al.
Reproducible bipolar resistive switching in entire nitride AlN/n-GaN metal-insulator-semiconductor device and its mechanism
[J]. Appl. Phys. Lett., 2014, 105(19): 1
[本文引用: 1]
[12]
Jiang Y Z,Cong H L, Xu X M, et al.
Al preseeding mechanism study of growing AIN on Si (111) Substrates by MOCVD
[J]. Semiconductor Technology, 2013, 038(004): 292
[本文引用: 1]
江忠永, 叢宏林, 徐小明等。
Si襯底上MOCVD生長AIN的預(yù)鋪鋁機理研究
[J]. 半導(dǎo)體技術(shù), 2013, 038(004): 292
[本文引用: 1]
[13]
Varshney A, Armaou A.
Optimal operation of GaN thin film epitaxy employing control vector parametrization
[J]. AICHE J., 2006, 52(4): 1378
DOI:10.1002/(ISSN)1547-5905 URL [本文引用: 1]
免責(zé)聲明:本網(wǎng)站所轉(zhuǎn)載的文字、圖片與視頻資料版權(quán)歸原創(chuàng)作者所有,如果涉及侵權(quán),請第一時間聯(lián)系本網(wǎng)刪除。
-
標(biāo)簽: 材料表面與界面 , 生長機制 , 金屬有機物化學(xué)氣相沉積
相關(guān)文章
無相關(guān)信息

官方微信
《中國腐蝕與防護網(wǎng)電子期刊》征訂啟事
- 投稿聯(lián)系:編輯部
- 電話:010-62316606-806
- 郵箱:fsfhzy666@163.com
- 中國腐蝕與防護網(wǎng)官方QQ群:140808414
文章推薦
點擊排行
PPT新聞
“海洋金屬”——鈦合金在艦船的
點擊數(shù):7214
腐蝕與“海上絲綢之路”
點擊數(shù):5804





