隨著信息產業的不斷發展與芯片制程工藝的不斷進步,微電子器件逐漸小型化、集成化和高功率化,散熱問題成為制約微電子器件進一步發展的瓶頸。傳統的電子封裝材料由于較低的熱導率(< 300 W m-1 K-1)已經不能滿足高功率電子器件的散熱需求,急需開發新一代具有高熱導率和低熱膨脹系數的電子封裝材料。近年來,金剛石顆粒增強鋁基(diamond/Al)復合材料具有較高的熱導率、可調控的熱膨脹系數和較低的密度,吸引了研究者的廣泛關注。目前,diamond/Al復合材料熱導率的最高值僅為770 W m-1 K-1,未能充分利用金剛石的高導熱特性,如何進一步提高diamond/Al復合材料的熱導率,是本領域主要解決的關鍵問題。
近日,北京科技大學張海龍教授與西安交通大學武海軍教授、北京航天航空大學趙立東教授合作,通過實現高界面熱導、大粒徑金剛石顆粒、高金剛石體積分數和高致密度的同時優化,獲得熱導率高達1021 ± 34 W m-1 K-1的diamond/Al復合材料(圖1),為目前報道金剛石顆粒增強金屬基復合材料熱導率的最高值,研究成果以題為Realizing ultrahigh thermal conductivity in bimodal-diamond/Al composites via interface engineering發表在Materials Today Physics(2022, 28, 100901)。
論文鏈接: https://doi.org/10.1016/j.mtphys.2022.100901

研究工作采用雙粒徑金剛石顆粒提高金剛石體積分數并實現大粒徑金剛石顆粒的致密化制備,通過優化非連續原位碳化物界面層提高界面熱導(圖2),利用多因素的協同作用,在diamond/Al復合材料的熱導率方面取得突破。該復合材料同時具有與半導體材料匹配的低熱膨脹系數(3.40 × 10-6 K-1)、較高的高溫熱導率和穩定的熱循環性能(圖3),能夠對高功率微電子器件進行有效散熱,有望替代現有電子封裝材料,推動電子封裝技術的發展。
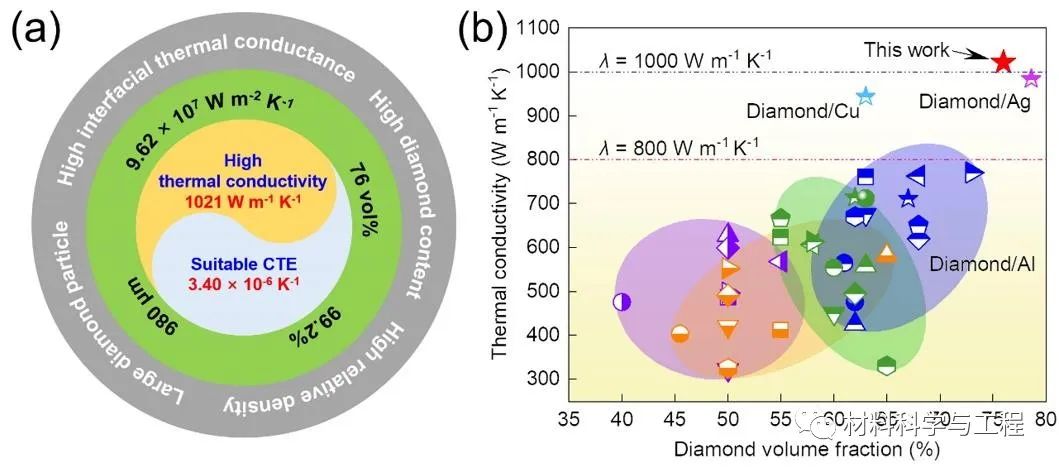
圖1. (a) Diamond/Al復合材料實現優異熱物理性能的策略:同時實現高界面熱導、大粒徑金剛石顆粒、高金剛石體積分數和高致密度的優化;(b) 熱導率與文獻對比。
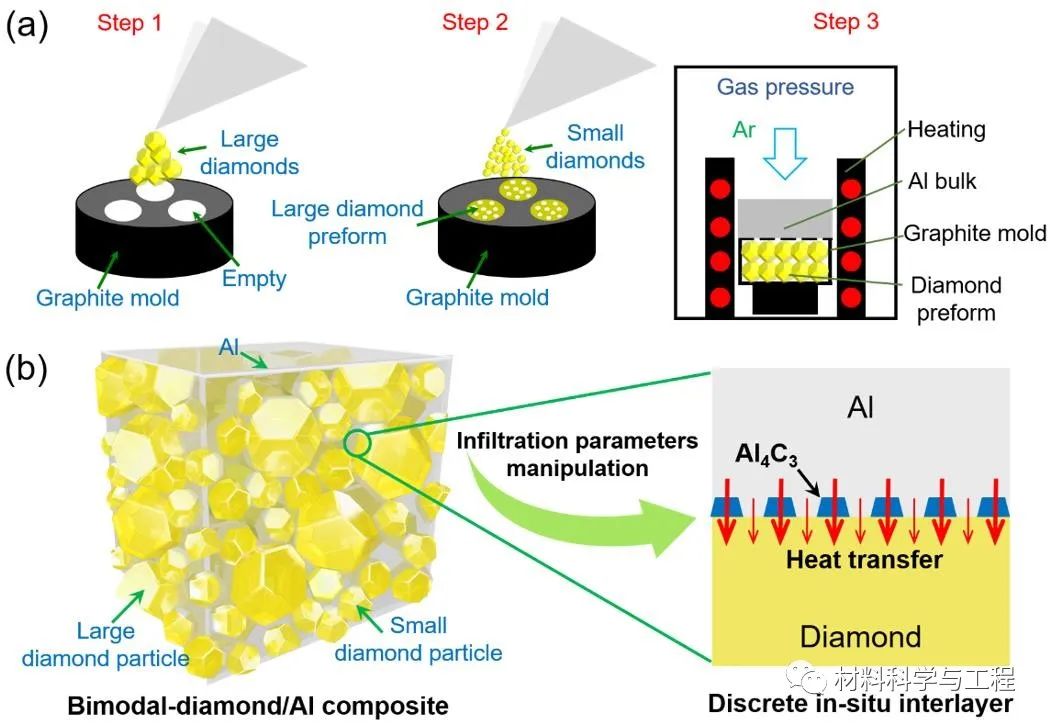
圖2. Diamond/Al復合材料同時實現高界面熱導、大粒徑金剛石顆粒、高金剛石體積分數和高致密度的優化方 案:(a) 雙粒徑金剛石顆粒提高金剛石體積分數并實現大粒徑金剛石顆粒的致密化制備;(b) 非連續Al4C3界面層實現高界面熱導。
案:(a) 雙粒徑金剛石顆粒提高金剛石體積分數并實現大粒徑金剛石顆粒的致密化制備;(b) 非連續Al4C3界面層實現高界面熱導。
圖3. Diamond/Al復合材料的熱物理性能:(a) 不同粒徑金剛石顆粒制備的復合材料的熱導率;(b) 298-673 K范圍內熱膨脹系數與半導體材料GaN、金屬Al、金剛石對比;(c) 比密度熱導率與diamond/Cu、diamond/Ag復合材料、高導熱金屬對比;(d) 高溫熱導率與diamond/Cu復合材料、金屬Cu和Al對比;(e) 熱導率隨218-423 K溫度范圍熱循環次數的變化。
免責聲明:本網站所轉載的文字、圖片與視頻資料版權歸原創作者所有,如果涉及侵權,請第一時間聯系本網刪除。

官方微信
《腐蝕與防護網電子期刊》征訂啟事
- 投稿聯系:編輯部
- 電話:010-62316606-806
- 郵箱:fsfhzy666@163.com
- 腐蝕與防護網官方QQ群:140808414





