7 納米芯片是當今已量產(chǎn)之最先進制程產(chǎn)品,金屬材料加入鈷(Co)是關(guān)鍵,但鈷(Co)真的完全取代原先的銅(Cu)了嗎?
人工智慧及大數(shù)據(jù)時代來臨,芯片也必須透過不斷微縮提升效能?然而面對7 納米先進制程,如何生產(chǎn)出效能更高、耗電更少、面積更小,又符合可靠度要求的芯片,是當今半導體制程上的重要課題。
當今,隨著摩爾定律,半導體7 納米先進制程已進入量產(chǎn)階段,從材料工程上來看,電晶體接點與導線的重大金屬材料進行變革,是解除7 納米以下先進制程效能瓶頸的關(guān)鍵。
這重大的金屬材料就是──鈷(Co)。然而坊間傳言以鈷(Co)取代銅(Cu)的真實性如何?
宜特材料分析實驗室這次直接實測已量產(chǎn)的7 納米芯片,帶您進入7 納米的微縮世界。

▲ 圖1
降低RC Delay,提升芯片運行速度
在積體電路中,「電阻─電容延遲時間」(RC Delay)是影響半導體元件的速度或性能的重要參數(shù)之一。
隨著半導體制程推進至7 納米,不僅金屬連線(interconnect)層數(shù)越趨增加,導線間的距離也不斷微縮;當電子訊號在層數(shù)非常多的金屬連線(interconnect)間傳送時,其產(chǎn)生的「電阻─電容延遲時間」(RC Delay),將嚴重減低半導體元件的速度。如何降低「電阻─電容延遲時間」(RC Delay)、增加半導體元件運行速度,是一重要課題。
IC 制程微縮,阻障層有相對增加電阻的風險
銅(Cu)和鋁(Al)是半導體后段制程(Back End Of Line,BEOL)金屬連線(Interconnect)最常使用的金屬材料。而銅主要會被用于先進制程的「金屬連線」,來自于銅導電性比鋁好,不過銅(Cu)原子在介電層的擴散系數(shù)遠比鋁原子大,為防止銅(Cu)擴散在介電層所造成線路短路。所以,在半導體制程,就必須使用更致密的「氮化鉭」(TaN),取代柱狀晶結(jié)構(gòu)的「氮化鈦」(TiN),借此避免銅擴散。
然而,此氮化鉭(TaN)比氮化鈦(TiN)的電阻系數(shù)大很多,相差十倍以上(參見表1),使用氮化鉭(TaN)為銅的阻障層,將會有使金屬連線電阻增加的風險。

▲ 表1:TaN 及TiN 電阻系數(shù)。
金屬線上的電阻為「銅線電阻」加「氮化鉭(TaN)層電阻」的總和。銅線尺寸大時,氮化鉭(TaN)層引起的電阻增加比例不大,可忽略不計。但是當芯片微縮到非常小,促使銅線的尺寸也逐漸縮小時,氮化鉭(TaN)層貢獻的電阻比例就愈來愈大。宜特材料分析實驗室使用并聯(lián)電阻簡化計算氮化鉭層電阻貢獻度(見表2)。銅線橫截面尺寸由200 納米降到20 納米,則氮化鉭層電阻貢獻度約增加大于40 倍。
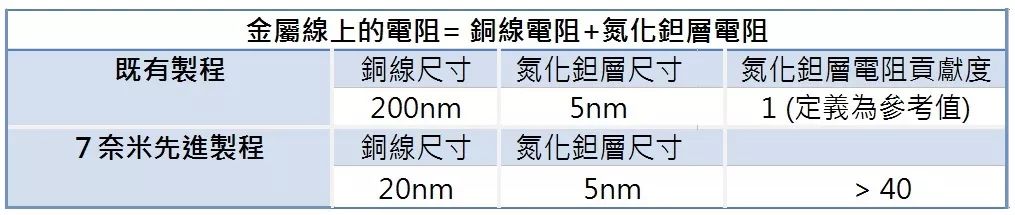
▲ 表2:氮化鉭層電阻貢獻度,利用并聯(lián)電阻簡化計算。
然而,在銅(Cu)制程中,因銅的容易擴散的特性關(guān)系,所以也不能藉由降低氮化鉭(TaN)層的「厚度」來減少電阻,否則就會失去阻障功能。因此在7 納米IC 制程中,使用新材料取代銅導線或阻障層變成很重要的課題。
降低7 納米芯片的電阻,金屬材料是選用是關(guān)鍵那該如何減低氮化鉭(TaN)層的電阻呢?調(diào)整該層的金屬材料就成為關(guān)鍵。經(jīng)研究,發(fā)現(xiàn)金屬鈷(Co)是加入氮化鉭(TaN)阻障層的極佳候選材料,鈷(Co)不但降低阻障層的電阻,而且可以降低阻障層厚度,一舉兩得。
雙層接觸窗設(shè)計,讓鈷(Co)發(fā)揮最大效能金屬導線和矽基板上半導體元件之間的連結(jié)稱為接觸窗(contact),主要是靠鎢(W)連結(jié),其阻障層材料是氮化鈦(TiN)。在銅金屬化制程中,如何降低W / TiN 的接觸窗的電阻,鈷(Co)又成為最佳候選者。但是,用鈷(Co)直接完全取代W / TiN 直接和銅接觸,則銅和鈷容易固溶在一起,造成金屬導線電遷移性能會變差。于是有了雙層接觸窗的制程設(shè)計。
實測7 納米制程芯片,透視鈷(Co)是否完全取代銅(Cu)剖析完為什么要使用鈷(Co)的原因后,宜特材料分析實驗室進行實測,一起來看看鈷(Co)是用在7 納米制程芯片的那些地方?鈷(Co)真的完全取代銅(Cu)了嗎?
前期樣品制備作業(yè)為了執(zhí)行分析7 納米先進制程產(chǎn)品的分析,宜特材料分析實驗室采購市售手機相關(guān)部品,取得Kirin 980 CPU。由于此CPU 是封裝在手機電路板上,必須先進行相關(guān)部品的拆解(Tear down),以及相關(guān)結(jié)構(gòu)觀察的分析工程,包括X 光分析、去錫球、去封裝、去膠、紅外線定位、研磨、吃酸、CPU / DRAM 雙芯片分離等技術(shù),最后終于取得Kirin 980 芯片。
利用TEM 實際觀察宜特材料分析實驗室利用穿透式電子顯微鏡(Transmission electron microscope,TEM),搭配高性能的能量散布X 射線譜術(shù)(Energy-dispersive X-ray spectroscopy,EDS / EDX),借此解析7 納米芯片的前段制程(Front End Of Line,F(xiàn)EOL)及后段制程(Back End Of Line,BEOL)。
宜特材料分析實驗室透過TEM 及EDS 觀察芯片結(jié)構(gòu)里頭第一層(M1)與第二層(M2)金屬層,解析7 納米的鰭狀電晶體(FinFET)、閘極(Gate)、接觸窗(Contact)(見圖2),與相對應(yīng)鈷(Co)及鎢(W)(見圖3)的成分分布。
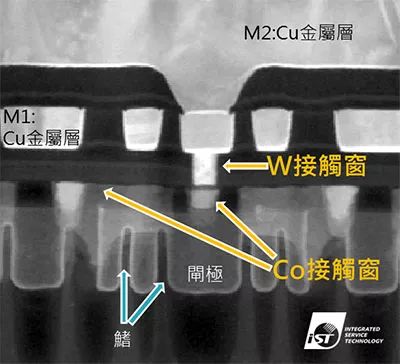
▲ 圖2:STEM HAADF 影像,顯示鰭狀電晶體、閘極、接觸窗、M1 和M2 等結(jié)構(gòu)。

▲圖3:桃紅色為鈷(Co)成分,草綠色為鎢(W)成分,對照圖2,即可了解鈷和鎢在結(jié)構(gòu)里分布的情形。
由圖2 及圖3 兩張圖比較,宜特材料分析實驗室觀察到鈷(Co)成為「接觸窗」及「阻障層」材料,而且鈷(Co)包覆了整個第一層(M1 )銅金屬層的結(jié)構(gòu),成為阻障層材料。但Co 沒有完全取代接觸窗的W / TiN,可能是因為接觸窗制程與阻障層制程使用不同類型制程,造成Co 與周圍材料反應(yīng)的狀況不同,致使接觸窗的Co 無法完全取代W/TiN。
結(jié)論由TEM 結(jié)果可知,鈷(Co)的用途并非取代銅(Cu)。鈷用在銅的阻障層,且只有取代一半的接觸窗。因此宜特材料分析實驗室得以證明鈷(Co)在7 納米先進制程產(chǎn)品,并未完全取代銅(Cu)。
免責聲明:本網(wǎng)站所轉(zhuǎn)載的文字、圖片與視頻資料版權(quán)歸原創(chuàng)作者所有,如果涉及侵權(quán),請第一時間聯(lián)系本網(wǎng)刪除。

官方微信
《中國腐蝕與防護網(wǎng)電子期刊》征訂啟事
- 投稿聯(lián)系:編輯部
- 電話:010-62313558-806
- 郵箱:fsfhzy666@163.com
- 中國腐蝕與防護網(wǎng)官方QQ群:140808414





